![]() PER MAGGIORI INFORMAZIONI: Marco V. Nardi - +39 0461 314849 - marcovittorio.nardi@imem.cnr.it
PER MAGGIORI INFORMAZIONI: Marco V. Nardi - +39 0461 314849 - marcovittorio.nardi@imem.cnr.it

La tecnica Ionized Jet Deposition (IJD) produce film in vuoto, con uno spessore che va da pochi nm ad alcuni micron. Si basa sul processo di ablazione in un materiale target indotto da un fascio di elettroni pulsati. Come avviene nella tecnica di Pulsed Laser Deposition technique (PLD), la creazione di vapori fisici è dovuta all'ablazione del materiale indotta da una grande quantità di energia assorbita in un volume molto piccolo. Le alte temperature raggiunte per l'eccitazione dei diversi livelli elettronici portano alla vaporizzazione di tutti gli atomi, creando un plasma che può essere raccolto su un substrato posto di fronte al target.
Nella tecnica PLD, il trasferimento di energia avviene grazie all'assorbimento di fotoni, con eventuali problemi nei materiali non otticamente attivi come gli isolanti. Inoltre, sono necessari laser ad alta fluenza e corta lunghezza d'onda, tipicamente in modalità pulsata, con la radiazione che deve essere convogliata dall’esterno all'interno della camera da vuoto, dove avviene l'ablazione. Nella tecnica di deposizione a fascio di elettroni pulsati (PED), l'ablazione è indotta da un impulso di elettroni ad alta energia (circa 1 J). La sorgente del fascio di elettroni si trova all'interno della camera a vuoto dove avviene la deposizione, di fatto migliorando l'affidabilità complessiva del processo e riducendo i costi e i rischi legati ai fasci di fotoni liberi in aria. Tuttavia, la PED è ancora lontana dall'essere una tecnica scalabile per applicazioni industriali, questo principalmente a causa del degrado di alcune parti della sorgente che richiedono frequenti manutenzioni.
La tecnica IJD sfrutta i fasci di elettroni, come PED, ma la sua sorgente ha un design diverso in modo da affrontare e risolvere la maggior parte dei problemi di manutenzione e ottenere una maggiore energia depositata (fino a 4J). In breve, i componenti principali della sorgente IJD e la geometria di deposizione sono illustrati in Figura. Per la deposizione di film sottile tramite IJD, un flusso di gas ionizzato (ad esempio, Ar+) passa attraverso un ugello di De Laval, convergente-divergente, che crea un fascio di gas supersonico nella sua parte in espansione. Questo getto di gas ionizzato entra in un catodo cavo a forma di cilindro, in cui gli elettroni del gas ionizzato si moltiplicano e vengono confinati elettrostaticamente in uno spazio equipotenziale. La rapida oscillazione degli elettroni all'interno del catodo cavo porta a una ionizzazione a valanga/cascata del gas, aumentando la densità di ionizzazione di ordini di grandezza (effetto catodo cavo). Successivamente, gli impulsi di elettroni ad alta densità vengono scaricati con una frequenza f ≤ 300 Hz (lunghezza d’impulso 100-300 ns) e sono diretti verso il target collegato a terra (| V | ≤ 30 kV, Ipicco ≤ 6 kA con un'energia dell'impulso finale E ≤ 4J). Il target è composto dal materiale che vogliamo depositare. Il fascio di elettroni pulsato altamente energetico abla un bersaglio rotante e produce una “piuma” di plasma di specie di dimensioni atomiche/molecolari, che vengono espulse e si propagano attraverso il catodo cavo verso il substrato rotante. Infine, le specie ablate si condensano sul substrato, formando un film sottile su una vasta area (ad esempio, coprendo wafer da 5 pollici o più grandi).
| Le nostre attività di ricerca riguardanti la IJD sono sviluppate in collaborazione stretta con la ditta Noivion S.r.l. (Italia). |
Highlights
Film sottili di MoS2 caratterizzati da proprietà tipiche di MoS2 a pochi layer, su substrati ad ampia area
Impieghiamo la ionized jet deposition (IJD), unita a trattamenti termici a 250 °C, per crescere film sottili di MoS2 in modo versatile e potenzialmente industrialmente scalabile.
Pur essendo spessi più di 100 nm, i film di MoS2 depositati con IJD films mostrano notevoli proprietà di tipo 2D, elettroniche e ottiche: sono caratterizzati da un bandgap di 1.86 eV e da spettri di fotoluminesceza (PL) ben risolti con una larghezza eccitonica inferiore a 10 meV. Questo comportamento è stato ottenuto grazie all’inclusione di nanostrati bidimensionali di MoS2 cristallino (a singolo o pochi strati) in una matrice di MoS2 amorfo (struttura “2D-in-3D").
Questi risultati rappresentano un punto di svolta verso la produzione di materiali “2D-like” su larga scala ed in modo accessibile.

"2D-MoS2 goes 3D: transferring optoelectronic properties of 2D MoS2 to a large-area thin film" – M. Timpel et al. - npj 2D Mater. Appl. 5 (2021) 64 - https://doi.org/10.1038/s41699-021-00244-x
IJD-MoS2: Ruolo del substrato e dei parametri di lavoro
Per studiare le possibili interazioni tra il target del plasma della IJD ed il substrato, ad esempio SiO2/Si, è stata investigata accuratamente l’interfaccia tra l’MoS2 “as-deposited” e il subtrato di SiO2/Si. E’ stata osservata la formazione di un interfaccia costituita da diversi ossidi di silicio, tra MoS2 ed il substrato di silicio, la cui formazione potrebbe derivare da processi di etching ed ossidazione da parte di molecole d’acqua nella camera da vuoto che si dissociano durante la crescita.
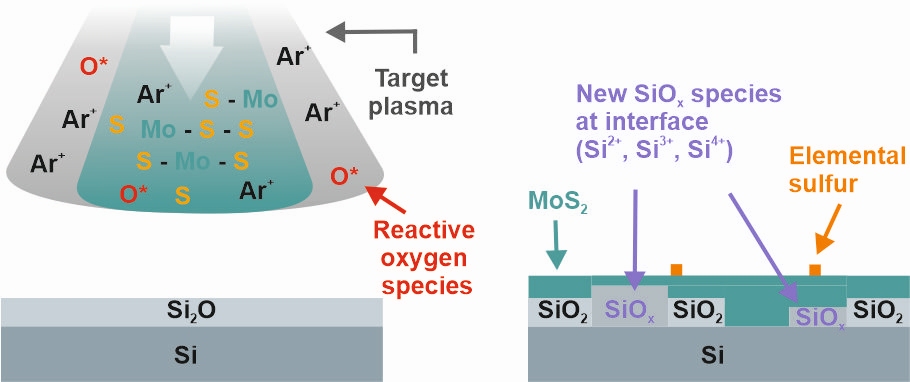
(a) prima della deposizione da ionized jet; (b) etching iniziale di ossido nativo di SiO2; (c) formazione di una superfice complessa di SiOx e crescita di film sottili di MoS2.
"Synthesis of MoS2 Thin Film by Ionized Jet Deposition: Role of Substrate and Working Parameters" – A. Ghiami et al. - Surfaces 3 (2020) 683 - https://doi.org/10.3390/surfaces3040045
Team members
 |
Marco Vittorio Nardi - Ricercatore - sede di Trento - marcovittorio.nardi@imem.cnr.it - sito web |
 |
Melanie Timpel - Ricercatore - sede di Trento - melanie.timpel@imem.cnr.it - sito web |
 |
Roberto Verucchi - Ricercatore - sede di Trento - roberto.verucchi@imem.cnr.it - sito web |
 |
Petr Nozar - Ricercatore - sede di Trento - petr.nozar@imem.cnr.it - sito web |









