Diffrazione ad alta risoluzione e mappe di reticolo reciproco
Setup e metodologia:
 |
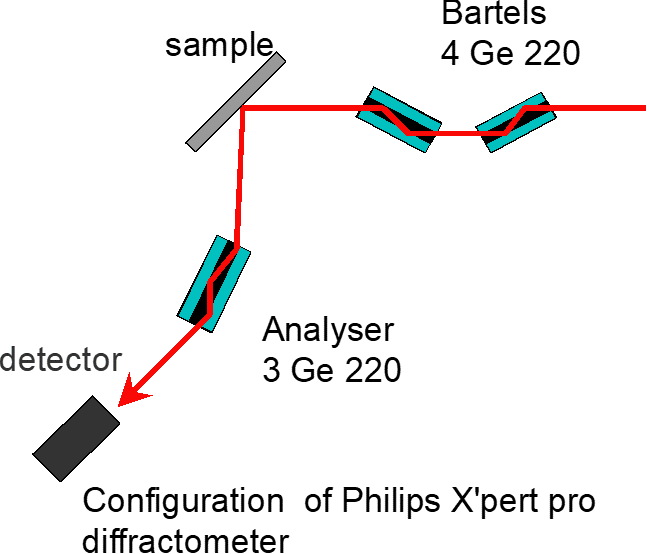 |
Diffrattometro X-Pert-Pro ad alta risoluzione con monocromatore Goebel e cristalli analizzatori sul fascio incidente e sul fascio diffratto in grado di ridurre la dispersione cromatica a 10-4 e la risoluzione angolare a 12 secondi d'arco.
Highlight:
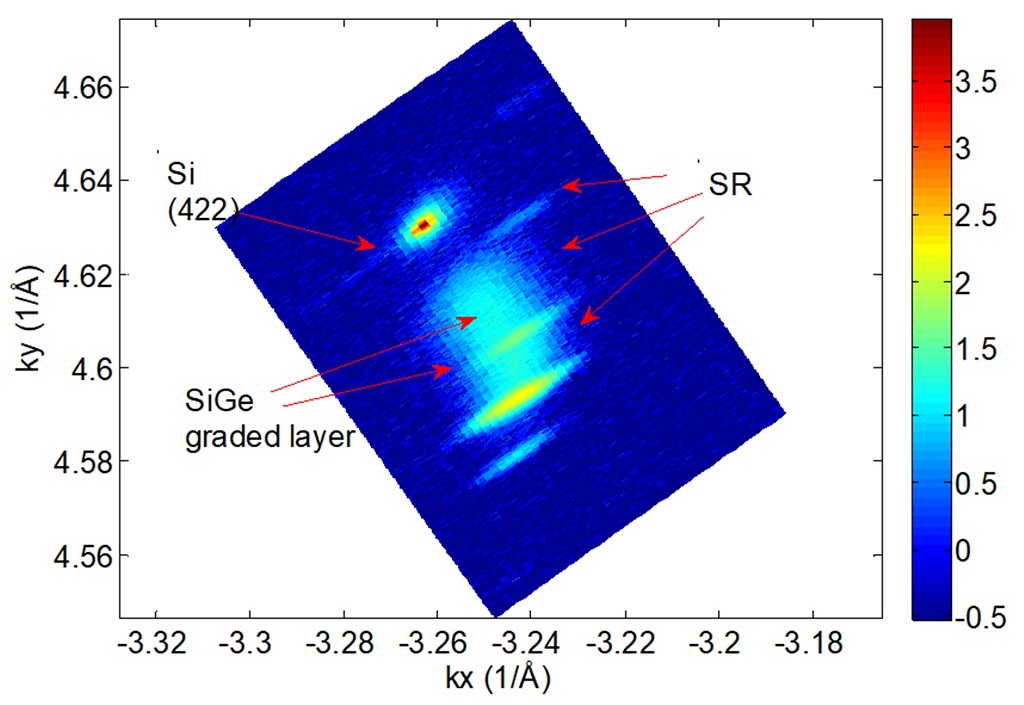
Mappa di reticolo reciproco di strati di SiGe e Ge alternati (SR) cresciuti su un buffer layer di SiGe a composizione gradata su substrato di silicio.
Metodo delle mappe polari e della misura della tessitura in film sottili e leghe
Setup e metodologia:
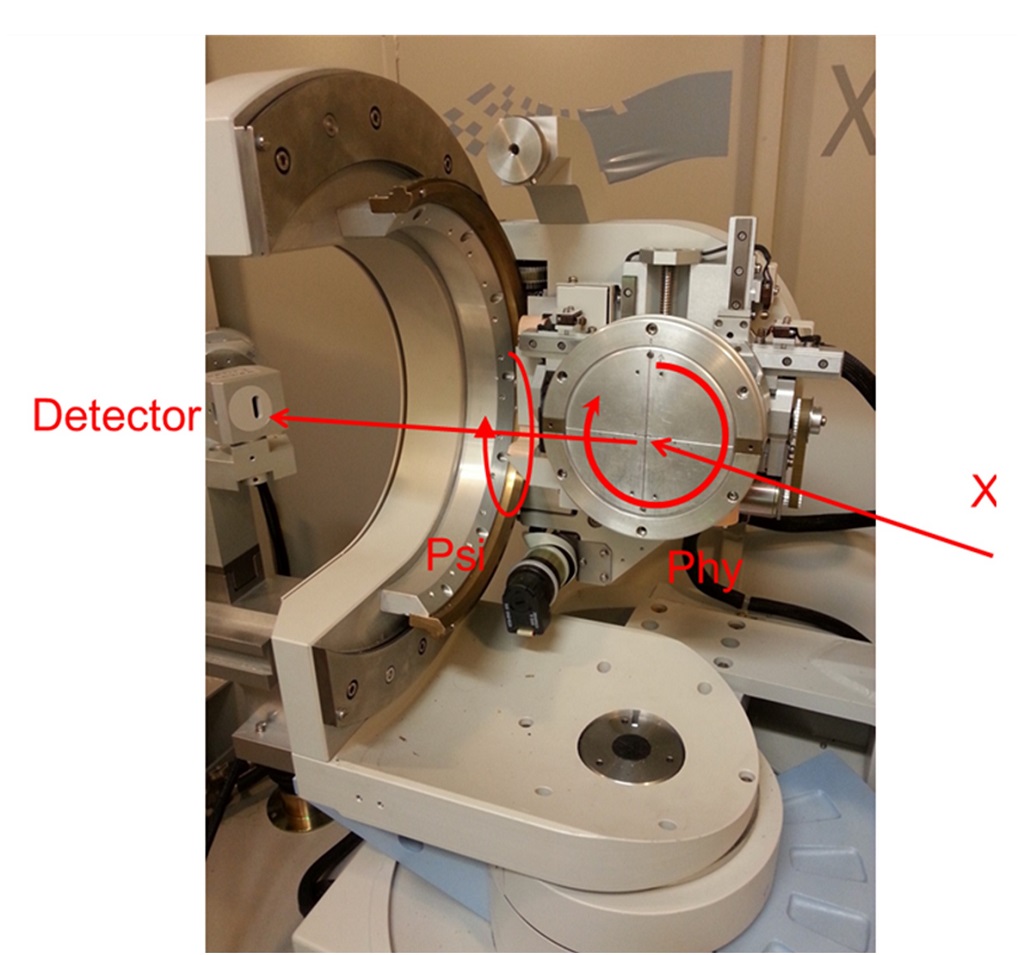 |
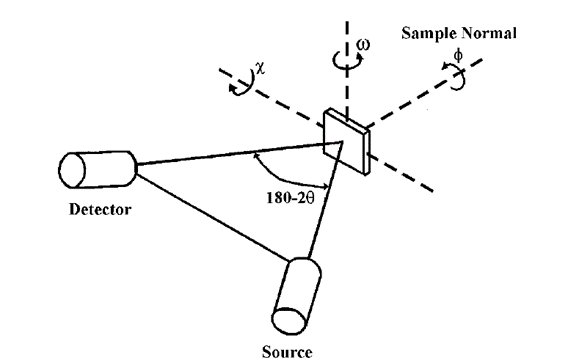 |
| Misura di "tessitura", mappe polari di film sottili e materiali | Schema di misura |
Highlight:
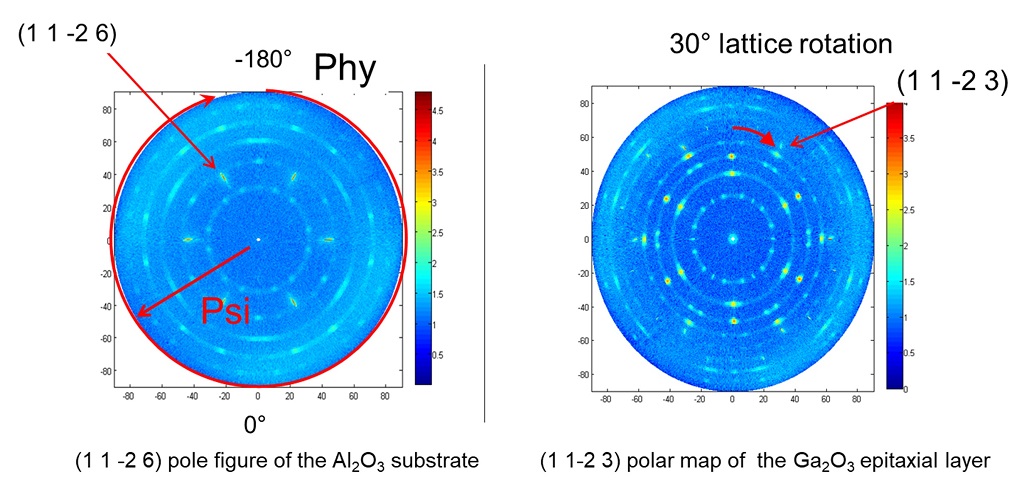
Mappe polari di un film di Ga2O3 su zaffiro, che mostrano la rotazione dei due reticoli.
Topografia a raggi X a doppio cristallo
Setup e metodologia:

Highlight:


Topografie a raggi X di un wafer di SiC, diffrazione 11-28, in presenza di dislocazioni (sinistra) e un bordo di grano a basso angolo (destra). Il lato orizzontale dell'immagine corrisponde a 3.3 mm.
Diffrazione da film sottili
Setup e metodologia:
 |
 |
Diffrattometro per film sottili con monocromatore Goebel
Highlight:

Profili di diffrazione di film di Ga2O3 su range angolare tra 10° e 150° depositati su subtrato di zaffiro.








