High resolution XRD and reciprocal space maps
Setup and method:
 |
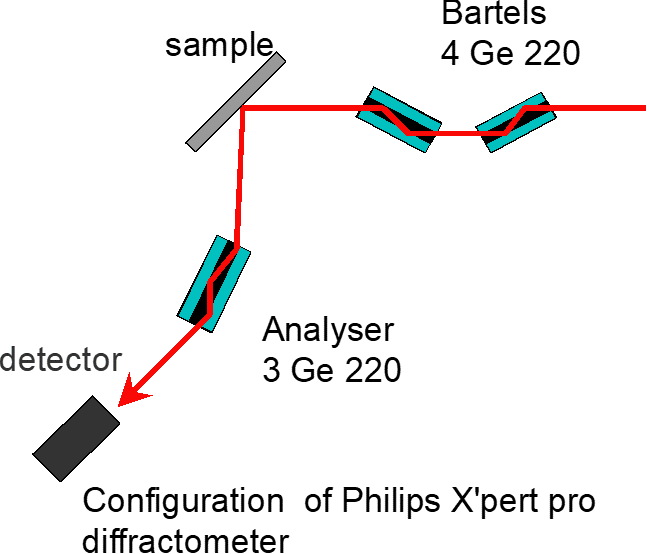 |
High resolution X-Pert-Pro diffractometer with Goebel monochromator and analyser crystals on both incident and diffracted beams, able to reduce the chromatic dispersion to 10-4 and the angular resolution to 12 arcsec.
Highlight:
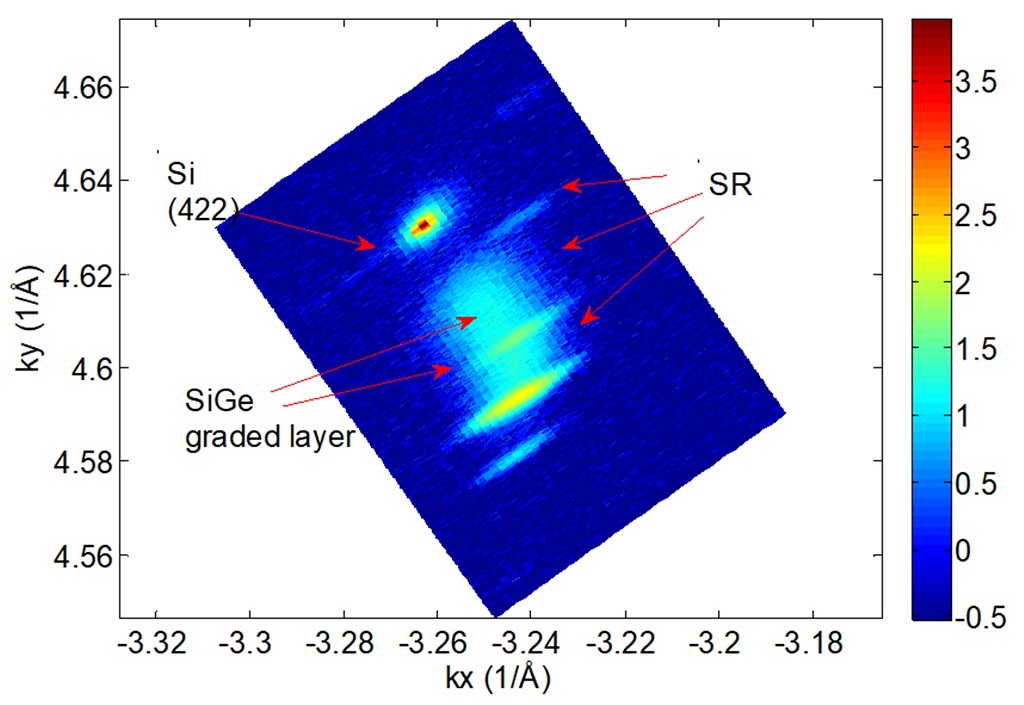
Reciprocal space map of a SiGe/Ge superlattice (SR) grown on a composition graded SiGe buffer layer on Silicon substrate.
Polar maps and texture measurement of thin films and alloys
Setup and method:
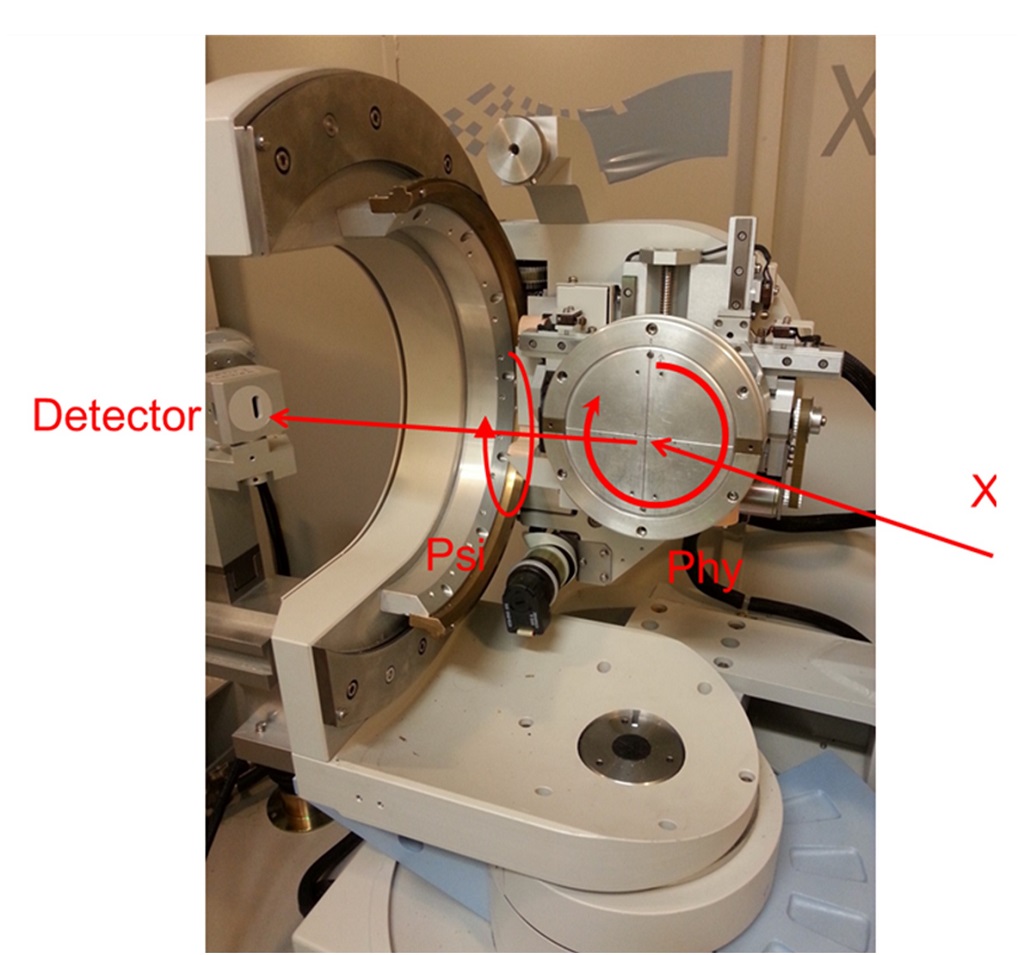 |
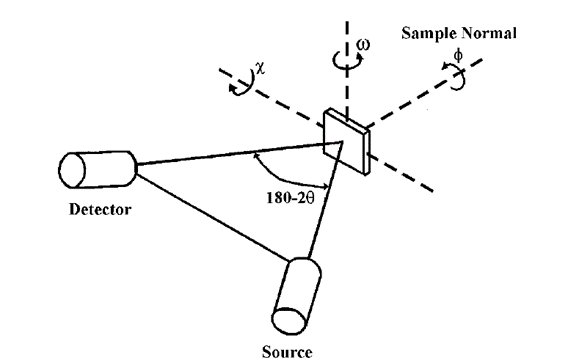 |
| Measurement of the"texture", polar maps of thin films and materials | Scheme of the measurement |
Highlight:
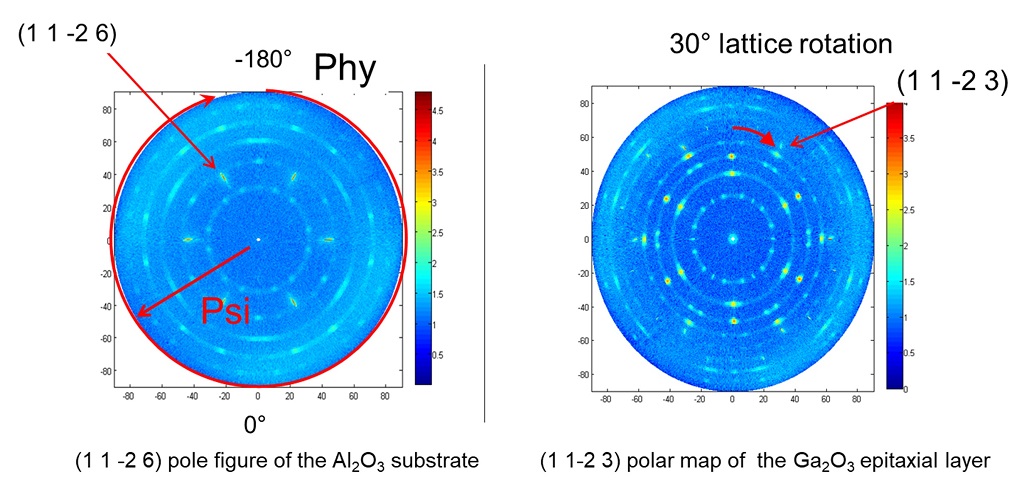
Polar maps of a Ga2O3 thin film grown on sapphire, showing the rotation of the two lattices.
Double crystal X-Ray topography
Setup and method:

Highlight:


X-Ray topographies of a SiC wafer, in 11-28 diffraction, showing dislocations (left) and a low-angle grain boundary (right). The horizontal side of the image corresponds to 3.3 mm.
XRD on thin films
Setup and method:
 |
 |
XRD setup with Goebel monochromator for measurements on thin films
Highlight:

XRD profiles of Ga2O3 thin films grown on sapphire substrates, acquired on an angular range 10° - 150°.








